Längenmaß für den Nanometer-Bereich
Stufen von Siliziumkristallen liefern präzises Maß für atomare Abstände.
Im Zuge der Revision des Internationalen Einheitensystems (SI), die am 20. Mai 2019 in Kraft getreten ist, hat die internationale Meterkonvention auf Vorschlag des beratenden Komitee für die Länge (CCL) zugelassen, den Gitterparameter des Siliziumkristalls – also den Abstand zwischen den atomaren Schichten – als Basis für die sekundäre Darstellung des Meters im Nanometerbereich zu nutzen. In der hochauflösenden Mikroskopie sind damit Unsicherheiten im Bereich von Pikometern für Messungen von Stufenhöhen bis zehn Nanometer erreichbar. Die PTB hat dafür kristalline Siliziumproben in reproduzierbar hoher Qualität hergestellt.
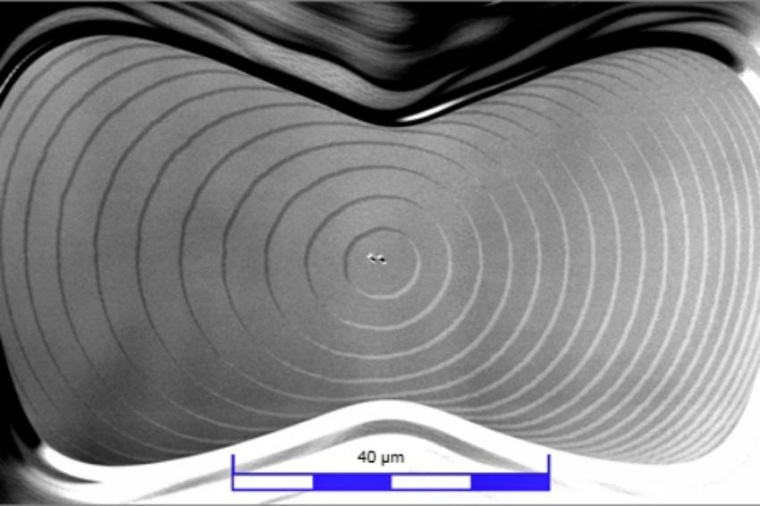
Das genaue Messen von Längen im Nanometerbereich ist eine besondere Herausforderung. Da für die Realisierung des Meters bisher im Wesentlichen Laser im sichtbaren Spektralbereich genutzt werden, ist bei dieser Art der Rückführung der Weg bis zum Nanometerbereich lang und beschwerlich. Als Folge sind sowohl die Unsicherheiten als auch die Kosten für den Anwender in der Praxis oftmals recht hoch.
Das beratende Komitee für die Länge (CCL) der Internationalen Meterkonvention hat im Zuge der Revision des SI in einer Mise en pratique den Gitterparameter des Siliziums als eine sekundäre Realisierung des Meters für dimensionelle Messungen in der Nanometrologie zugelassen. Daraus ergibt sich die Möglichkeit, substanzielle Fortschritte in der dimensionellen Kalibrierung von Rasterkraftmikroskopen zu erreichen, denn der Gitterparameter im Si-Volumenkristall ist mit relativen Unsicherheiten kleiner als 10–8 verfügbar.
Im Rahmen des europäischen Metrologie- Forschungsprojekts „Crystal“ wurden in der PTB kristalline Siliziumproben in reproduzierbar hoher Qualität hergestellt, bei denen die Höhe einer Monolage Silizium 0,314 Nanometer beträgt. Vergleichsmessungen in unterschiedlichen Metrologieinstituten belegen, dass mit diesen kristallinen Normalen für Messungen kleiner Stufenhöhen auf der Nanometerskala eine erweiterte Unsicherheit von zehn Pikometern erreicht werden kann. Das ist eine Verbesserung gegenüber bisherigen Methoden von mehr als einer Größenordnung.
Hergestellt werden diese Normale durch einen Selbstorganisationsprozess im Ultrahochvakuum auf Siliziumwafern mit (111)-Orientierung. Durch eine spezielle Prozessierung wird erreicht, dass das Kristallgitter des Wafers an der Probenoberfläche ungestört rekonstruiert wird. Damit ist sichergestellt, dass die Atome an der Oberfläche genauso regelmäßig angeordnet sind wie in der Tiefe des Kristalls. In einer neuen Präparationskammer soll dieses Verfahren auf noch komplexere Anwendungsfälle ausgeweitet werden.
PTB / DE